
当社は創立以来半導体工場として生産を続けて参りました。
40年に及ぶ歴史の中で、生産体制の拡充を始めとして品質保証体制や設備の改善などを行い、
時代の求める工場として実績を積んで参りました。
更なる次代へと発展を続けていくために、最新の技術に注目しつつ、蓄えられた知識や技術を応用し、
皆様のご要望にお応えして参ります。
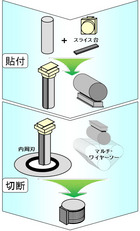
棒状に加工されたシリコン素材を,内周刃式スライサーやワイヤーソーなどで厚さ300μから1000μ(0.3mm〜1mm)程度に決められた厚みで切断します。インゴットは,社内で支持材と貼り付けられます。
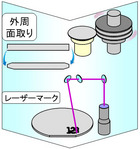
1枚ごとに剥がされ洗浄されたウェハは,エッジグラインダー装置で外周部を研磨されます。
ウェハ外周部には,ノッチ形状や直線部が有り,コンピューターによるNC制御によって非常に精度良く仕上げられます。
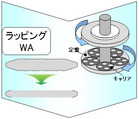
WA砥粒を使用し、同一製番のインゴットを決められた厚みにします。
両面ラッピングマシーンにより,ウェハ両面の加工歪み層を取り除きます。
非常に精度良く均等な厚みに仕上がります。
(誤差数μ以内での仕上がりです)
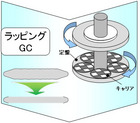
GC砥粒を使用し、前加工時のダメージ層を除去します。
また、狙い厚みに、板厚を揃えます。
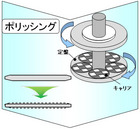
研磨スラリー(酸化セリウムや、コロイダルスラリー)を使って、鏡面に仕上げます。

内周刃切断機
ステンレス製ドーナツ状円板の内周にダイヤモンド砥粒を電着した刃具を回転させ硬脆材の薄切りを行う。

マルチワイヤーソー
多数の細いワイヤー(φ0.1前後)に、砥粒と特殊切断液を用い同時に多量のラップ切断する精密加工で、切断除去量が少なく且つ常時ボビンにより繰り出される新鮮なワイヤーによる加工のため、高精度加工が可能です。
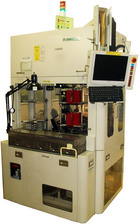
ウェハー端面形状研削機
スライス後のウエハー1枚1枚の外周部をダイヤモンドホイールで面取加工。切断時の外縁部加工歪層の除去に加え、正円に整え直径・オリエーテーションフラットが決定される
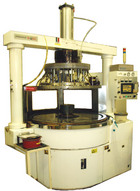
両面高精度研磨装置
WA砥粒を使用し、スライス時に残されたウェーハ表面の加工歪層を除去し、厚みを均一にしムラを無くすため、両面研磨を行う。
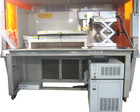
レーザーマーカー
ワークの識別管理のために、表面にロットなどをYAGレーザーにより刻印します。

両面ラップ機
GC砥粒を使用し、表面を両面ラップ加工することで、加工歪を取り除き、厚み平坦度精度を上げることができます。
また、砥粒を2種類(#1000、#1200)使っており、用途に応じて変更可能です。

DPG(ダイヤモンド・ベレット・グラインディング)研磨機
硬度の高い、難削材料であっても、ダイヤモンドペレットを使い、表面加工歪層を除去し、厚み・平坦度精度を上げることができます。

片面ポリッシュ機
酸化セリウムやコロイダル・スラリーを使って、ワーク表面を片面ずつ鏡面に仕上げます。
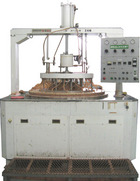
両面ポリッシュ機
酸化セリウムを使って、ワークの両面を同時に鏡面仕上します。

レーザー加工機
複雑な形状であっても、CO2レーザーを使いCAD図面通りに高速で高品位に切断できます。
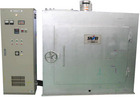
電気炉
レーザー加工後に、ワークの加工歪を熱処理により除去します。
お客様のインゴットに対する加工内容を書面にて頂き、当社内設備にて貼り付け〜ラップまでを行います。
お客様の指示により、単一工程での処理も可能です。
インゴットをすべて加工せず、指定枚数のみの加工も可能です。残りのインゴットは返却、または当社での保管と成ります。
お客様の希望する直径、取得枚数などの詳細を書面にて頂き,当社で手配致します。ただし、インゴットの手配に多少の時間を頂きます。インゴット取得後、御指示内容によりウェハ加工を致します。
スライス時の研削液、ワイヤーソーでの研削液、ラップ時の研磨剤などのテストについては,打ち合わせをさせて頂きます。当社内の装置などの指定をして頂いてテストさせて頂きます。
守秘義務契約を締結後のテストになりますので、安心です。
セラミック・サファイアなどの硬脆性材料を当社の設備において、可能な限りお客様のご要望に応じた加工を致します。
詳しい内容についてのお問い合わせは、下記メールアドレス、もしくは電話にてご確認ください。
☆☆☆ mail:egusa@shinsei-m.com ☆☆☆
TEL:0985-85-3700
当社は半導体加工において様々な加工サービスが可能です。
お客様のご期待に添えるよう、付加価値の高い商品を提供させて頂くために、
当社の確かな技術をもってお客様のご期待にお応えします。

更なる次代へと発展を続けていくために、最新の技術に注目しつつ、蓄えられた知識や技術を応用し、皆様のご要望にお応えして参ります。